- 易迪拓培训,专注于微波、射频、天线设计工程师的培养
BGA锡球断裂(crack)的红墨水测试判断与现象分析
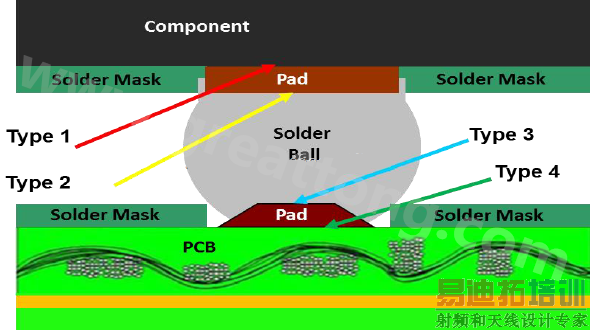
BGA-IC功能不良真的是很多PCBA电子公司的痛,尤其现在的CPU几乎全都采用BGA封装,当有开机不良品从客户端退回,需要分析不良原因时,最常采用的就是红墨水测试(Red Dye Test)法了,因为红墨水测试的好处是可以让人一目了然,了解整颗BGA在哪些位置有锡球发生了裂缝(crack)问题,方便制程及研发单位快速了解可能原因与可能的应力(Stress)来源。
不过,这红墨水测试其实是一种破坏性测试,建议一定要等到所有非破坏性的可行方案都试过了,最后才做这个红墨水破坏性测试。做过红墨水测试的样品,理论上还是可以再拿去做切片(Cross-Section)做进一步的SEM(Scanning Electron Microscope)显微照相及EDX(Energy-Dispersive X-ray spectroscopy)金属元素分析,但样品毕竟已在红墨水测试时曾经过外力破坏,而且部分区域可能被红墨水或其他物质污染,也就是已非第一现场,所以后续的分析结果就会被持以保留态度。
另外,红墨水测试无法判断PCB内层是否有问题,有些不良原因可能是PCB的导通孔(via)断裂,或是内层微短路(CAF, Conductive Anodic Filament)所造成,一旦做了红墨水测试,这些现象就可能会消失或被破坏。
所以,一般比较谨慎的作法是先用电性测试的手法,尽可能找到是那几颗锡球与线路可能出现了问题,然后抽丝剥茧,一步步的排查缩小可能范围,最好还要分得出来是开路还是短路,最后直接做切片,直捣黄龙,一掷中的。
不过本人还是以红墨水试验为淮来做说明,下面是一般实验室(lab)做红墨水试验后所出的报告格式,有些实验室可能会有少许的不同,但表示方法都大同小异。
BGA红墨水锡球断裂面Type表示:
配合最上面的BGA锡球断裂面的图示,下面用颜色来代表锡球(ball)的断裂面。
Type 0 锡球无裂缝
Type 1 裂缝发生在锡球与零件焊垫底层之间。 零件焊垫与本体剥离。焊锡性良好。
Type 2 裂缝发生在锡球与零件焊垫表层之间。 零件焊垫完整,断裂在零件端焊锡面。
Type 3 裂缝发生在锡球与PCB焊垫表层之间。 PCB焊垫完整,断裂在PCB端焊锡面。
Type 4 裂缝发生在锡球与PCB焊垫底层之间。 焊垫与PCB本体剥离。焊锡性良好。
以上的分类中还缺少一样,就是裂缝发生在锡球的中间,一般来说红墨水测试(Red-Dye)如果发现有缝隙发生在锡球的中间,就有很大的可能性是SMT有问题,可能是HiP(Head-in-Pillow)/HoP(Head-of-Pillow)现象或锡球内孔洞(Void)过大造成断裂。
如果是Type 1 或 4 缝隙发生在焊垫底层,一般认为是应力(Stress)所造成的机率最大,而应力可能来自PCB板弯,组装制程中应力(比如说锁螺丝、针床测试),使用者弯曲产品,或使用者不小心摔落桌面或地面锁造成。虽然已经可以证明焊锡(Solderability)没有问题,但也不排除零件或PCB经过多次回焊高温洗礼后造成焊垫的Bonding-Force降低的影响,一般来说焊垫都可以在三次以内正常焊锡而不会脱落,如果PCB或BGA零件经过多次重工或不当高温,也有很大可能造成焊垫脱落的现象。
如果是Type 2 或 3 缝隙发生在焊垫表层,一般认为也是应力(Stress)所造成的机率最大,其次也有可能是「NWO(Non-Wet-Open)」焊锡问题所造成,正常情况下由有经验的工程师在显微镜下观察就可以判断是否与焊锡有关,断裂面如果层光滑亮面则可能为焊锡问题,如果判断不出来就必须再进一步做切片(Cross-Section),检查IMC(Intermetallic Component)的生成状况以做判断,如果是ENIG的版子,可能还得打EDX看是否有「黑垫(Black pad)」现象,不过如果是黑垫也不应该只有BGA有问题,其他零件多多少少也会出现问题才对?
延伸阅读:
如何从设计端强化BGA以防止其焊点开裂?
[案例]BGA锡球开裂不良,利用应变计确认机构设变对策前后改善
如何从红墨水测试中判断BGA开裂的不良原因
BGA锡裂,使用应变片(Strain Gauge)量测电路板到底那个环节产生较大变形量
BGA红墨水锡球断裂百分比Type表示(%):

Type 0:锡球无裂缝
Type A:锡球裂缝介于锡球总面积的1~25%。视状况判断可接受与否。
Type B:锡球裂缝介于锡球总面积的25-50%。不可接受。
Type C:锡球裂缝介于锡球总面积的50~75%。不可接受。
Type D:锡球裂缝介于锡球总面积的75~100%。不可接受。
正常来说只要BGA的锡球有裂缝就不能接受,只是有些裂缝是因为锡球中的空洞/气泡所造成,根据 IPC-7095B 7.5.1.7规格更新,现在BGA锡球内的气泡淮统一要求要不得大于25%(直径)或6.25%(面积)。
BGA红墨水测试锡球断裂对照表:

BGA红墨水测试锡球断裂对照表:
从下面不良对照表可以发现,BGA锡球开裂的现象出现在左手边的上下两个角落,这也与我们一般看到电路板因为应力(Stress)所造成的BGA锡球开裂不良现象类似,应力最大的作用力出现在BGA-IC的四个角落,而这个位置又位于电路板的正中间位置,也是电路板板弯时应力出现最大的位置。
如果可能的话,工作熊强烈建议BGA的四个角落的位置不要有锡球设计,也可以考虑设计没有线路的假(dummy)锡球,既可以加强BGA的应力承受度,如果有裂缝问题,也不会影响到功能。
BGA红墨水测试锡球断裂对照表

BGA红墨水测试的照片与实际锡球开裂现象

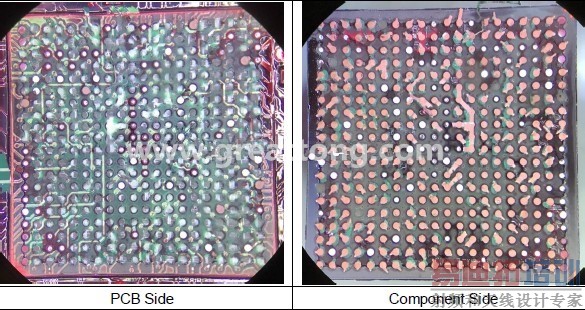
从照片中锡球开裂的情形来判断A1-C1及U1-Y1刚好在BGA位于电路板中间位置的上下两个角落,所以极有可能是电路板因外力变形所造成的锡球断裂。请注意一下,这份报告有一个地方标示错误,在C1的位置锡球的断裂面应该在零件面(Component Side,黄色底),但实验室大概忙中有错,标成了蓝色底的PCB面了。
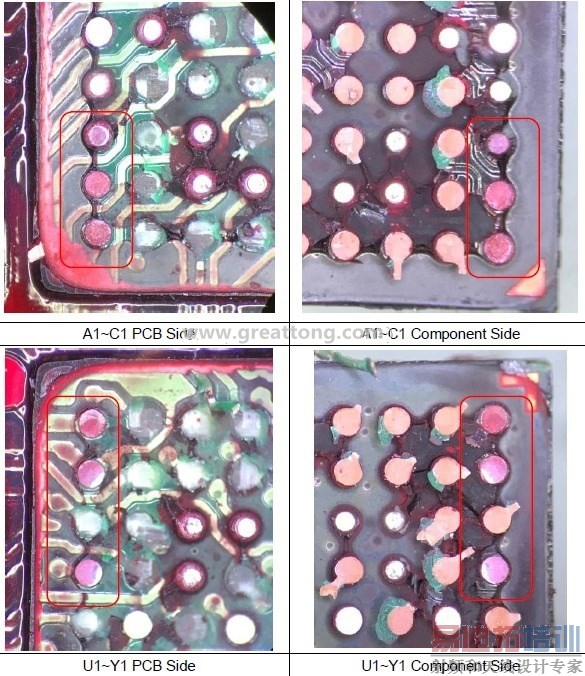
而U20位置的25~50%锡球裂开看起来有点像是气泡所造成。
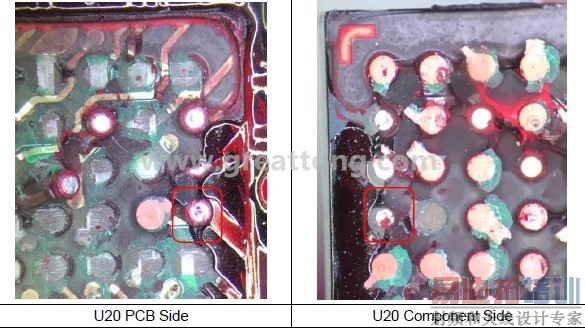
延伸阅读:
如何从红墨水测试中判断BGA开裂的不良原因
如何着手分析市场返修的电子不良品及BGA不良
如何判断BGA掉件是SMT工厂制程或是设计问题
简介用红墨水试验 (Red Dye Penetration Test)查看BGA焊锡有否破裂
为什么IMC已经形成有效焊接但零件掉落还是发生IMC层断裂之观念澄清
射频工程师养成培训教程套装,助您快速成为一名优秀射频工程师...
天线设计工程师培训课程套装,资深专家授课,让天线设计不再难...
上一篇:PCB设计的五大设计关键点
下一篇:整理SMT回流焊接缺点、可能原因及其对策

