- 易迪拓培训,专注于微波、射频、天线设计工程师的培养
高电容比射频/微波MEMS膜开关理论分析和数值模拟
录入:edatop.com 点击:
高电容比射频/微波MEMS膜开关理论分析和数值模拟*
龙永福1,2,赖宗声1,朱自强1
(1.华东师范大学电子系,上海 200062;2.常德师范学院物电系,常德 415000)
摘 要:建立了一个MEMS膜开关电容比理论模型。由于这个模型比较全面地考虑了开关阈值电压、维持电压、偏置电压和介质膜内的电场强度等因素对电容比的影响,因而能较为正确地反映开关的电容特性。用数值方法计算了影响开关电容比的因素,并对计算结果进行了分析和讨论。提出了使用脉冲电压作为偏置电压可以使介质膜gi的厚度减少到50nm,从而使开关的电容比增加到3800。最后,讨论了实现高电容比MEMS膜开关的可行性。
关键词:MEMS膜开关,电容比,阈值电压,维持电压
1 引言
近40年来,开关作为信号变换的关键器件之一,在射频/微波集成电路中已经大量使用FET和PIN等半导体管开关。由于这类开关具有较低的工作频率、较大的插入损耗、较低的隔离度及其固有的非线性特性,导致半导体开关存在许多缺陷。近10年来,随着微电子技术的飞速发展,出现了微机电系统(MEMS,Micro-Elecgtro-Mechanical Systems)技术。人们可将微电子元件和微机械元件结合在一起构成了微型化器件和器件阵列。MEMS开关作为射频/微波电路中的最基本的信号变换元件,已经是一种获得广泛研究的器件[1,2]。MEMS开关与传统的p-i-n二极管开关及FET开关相比,由于消除了p-n结和金属-半导体结,也消除了由于半导体结引起的I-V非线性,因而显著地减少了开关的谐波分量和互调分量。MEMS膜开关[3,4]通过在信号一和可支桥之间添加一层绝缘介质,可以减少静摩擦力且消除了微连接,从而提高了开关的稳定性和电性能。由于不需直流电流驱动,静电驱动MEMS膜开关仅需少的瞬间能量,其典型值大约是10nJ。典型MEMS膜开关的插入损耗随信号频率的增加而增加,从小于01dB(1GHz)增加到0.25dB(40GHz);隔离度随信号频率的增加而减少,从40dB(40GHz)[5]。因此,MEMS膜开关是半导体开关较好的替代品,且已经作为射频/微波无源器件应用到了微波电路中,如微开关、微相移器、微振荡器和微相控阵列天线等。MEMS膜开关的插入损耗和隔离度与开关在导通和截止时的耦合电容比值大小有关。为了减少开关导通时的插入损耗,开关在‘开’态时的耦合电容Con应尽可能小;而为了提高开关在断开时的隔离度,‘关’态时的耦合电容Coff应尽可能大。这样,MEMS膜开关的电容比值Coff/Con是开关性能特性的关键参数之一。据文献报道,现有开关的电容比通常为30~80。而要较大幅度地增加开关的电容比值Coff/Con,瓶颈是:在开关的整个开启时间内,所加的偏置电压为矩形信号Vp,当介质膜的厚度小于100nm时,氮化硅介质膜会电击穿[5],从而导致开关不稳定或失效。
本文提出将外加偏置电压Vbias改为脉冲电压,并降低绝缘介质膜的厚度,则开关的电容比Coff/Con可能增加,且不会导致介质膜电击穿,从而极大地提高MEMS开关及其衍生器件的性能。
2 基本理论
MEMS膜开关的结构示意图如图1、2所示。在外加偏置电压的作用下,可动桥向介质层移动。MEMS膜开关在运行过程中,必须确保在最小外加偏置电压的作用下,绝缘介质膜不被电击穿,而能得到开关的最大电容比,从而提高开关的性能。本文从理论上分析了影响MEMS膜开关电容比的因素,并数值分析了高电容比开关实现的可行性。

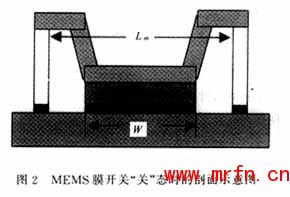
2.1 阈值电压
典型MEMS膜开关的示意图及其结构参数如图1、2所示。为了开启MEMS开关,CPW中间传输线与可动桥之间必须加直流电压。可动桥在静电力拖动下向介质层移动,共有两个力(忽略空气的阻力)作用在可动桥上。第一个力为静电力Fe,它是由偏置电压Vbias产生,其大小由有关的电学知识可得:

其次是可动桥受到的弹力,其大小为:

其中z为可动桥离开平衡位置的位移。
其中z为可动桥离开平衡位置的位移。
为了将可动桥拉下,静电力必须大于可动桥受到的弹力,其阈值电压Vp[5]为:

其中ε0
Y为可动桥材料的场氏模量,d为可动桥的厚度,Lm为可动桥的长度,δ为桥材料内部残存的张应力,γ为桥材料的泊松比。为真空介电常数,W为共面波导(CPW)中间传输导体的宽度,w为可动桥的宽度,g0为可动桥离介质层上表面的标称高度,k为系统可动总值发的有效弹性系数,且由文献[6]可得:

其中ε0
Y为可动桥材料的场氏模量,d为可动桥的厚度,Lm为可动桥的长度,δ为桥材料内部残存的张应力,γ为桥材料的泊松比。为真空介电常数,W为共面波导(CPW)中间传输导体的宽度,w为可动桥的宽度,g0为可动桥离介质层上表面的标称高度,k为系统可动总值发的有效弹性系数,且由文献[6]可得:
2.2 维持电压
当可动桥被拉下后,开关断开。为了维持开关断开状态,作用在可动桥上的静电力必须大于或等于其弹性恢复力(忽略表面分子间的范德华力和液体的表面张力(如果有水分的话)),否则,可动桥被弹起。通过建立静电力和其弹性恢复力两力平衡方程,可以由公式(1)、(2)求得其维持电压Vw,其大小为:

公式(5)为MEMS膜开关维持"关"态所需要的最小偏置电压。
公式(5)为MEMS膜开关维持"关"态所需要的最小偏置电压。
2.3 电容比
MEMS膜开关的电容比是衡量MEMS膜开关性能的重要特性之一。理想情况下要求开关在"开"态时的电容值为零,而在"关"态时的电容值为无穷大。如图1、2所示,MEMS膜开关的总电容是由可动桥下表面与介质层上表面之间的空气层所构成的电容Cair和介质膜层的电容Cj串联组成。当偏置电压Vbias加在可动桥与CPW中间传输线上时,静电力拖动可动桥向介质层移动。在可动桥小形变的情况下,可动桥与介质层之间的空气层电容Cair可近似为一可变平行板电容器[5],其大小随可动桥离开平衡位置的位移z而变化,且其大小Cair可表示为:

当MEMS膜开关处于"关"态或激活时,"关"态电容仅仅由介质层组成,也可以近似看成平行板电容器,且可以用下列公式计算:

同时,当开关处于"开"态或未被激活时,"开"态的电容Con由介质层电容Cj和空气层的电容Cair串联而成,且可由下式计算:

当MEMS膜开关处于"关"态或激活时,"关"态电容仅仅由介质层组成,也可以近似看成平行板电容器,且可以用下列公式计算:
同时,当开关处于"开"态或未被激活时,"开"态的电容Con由介质层电容Cj和空气层的电容Cair串联而成,且可由下式计算:

其中εr为介质膜的相对介电常数。
由公式(9)可知,要增大开关的电容比,可以减少gi,增加g0或增加介质的相对介电常数εr。
2.4 介质膜内的电场强度
为了确保MEMS膜开关在"开"和"关"过程中运行稳定,要求介质膜内的电场强度不能大于或长时间在介质的击穿电场附近工作。据文献[5]报道,限制MEMS膜开关电容比较低的原因是:如果介质膜gj太薄,在外加偏置电压的作用下,开关在动作过程中,介质膜内的电场强度有可能大于介质的介电强度(击穿电场)或长期在介质的击穿电场附近工作,从而导致开关工作不稳定或过早失效。在偏置电压的作用下,偏置电压加在两串联电容Cair、Cj上。可动桥在移动过程中,介质膜内的电场强度可以表示为:

由(6)、(10)式,当可动桥从平衡位置向介质膜运动时,Cair的电容逐步增加,偏置电压Vbias逐渐加在介质膜上,从而使介质膜内的电场强度逐步增大。

由(6)、(10)式,当可动桥从平衡位置向介质膜运动时,Cair的电容逐步增加,偏置电压Vbias逐渐加在介质膜上,从而使介质膜内的电场强度逐步增大。
3 数值结果
为了分析MEMS膜开关的电容特性,研究了在不同偏置电压的作用下,不使介质膜电击穿的条件下,开关"关"态与"开"的电容比与介质膜的厚度和偏置电压等因素之间的关系。根据目前已经检索的文献[2-4]报道,启动MEMS膜开关的偏置电压均是矩形波信号,且其幅度为阈值电压。使用矩形波信号、正弦波信号和脉冲波信号等3种信号作为偏置电压,对MEMS膜开关的电容比变化规律进行了数值分析。为了研究MEMS膜开关的电容比Coff/Con与偏置电压之间的关系,使不同偏置电压作用下数值计算结果具有可比性,在具体的计算中,开关的结构参数采用文献[4]中的典型值。组成可动桥的材料为Au,其详细的输入波形图、器件结构参数及数值计算结果如图(3)~(7)所示。

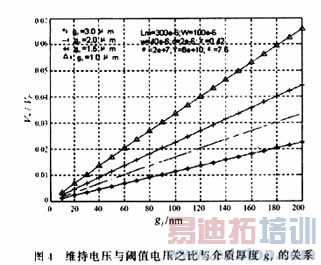
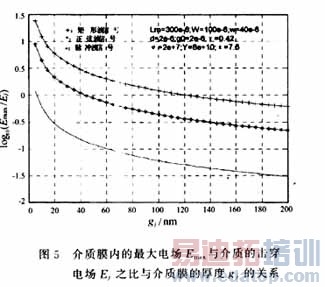
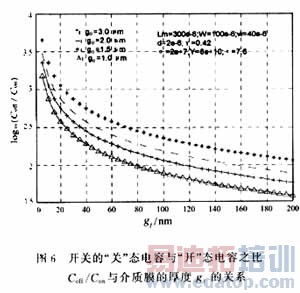
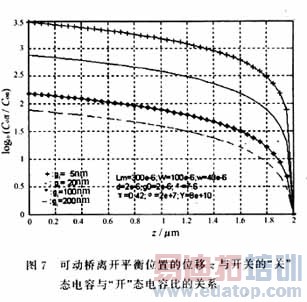
4 结论
本文就MEMS膜开关的重要特性—电容比进行了详细的理论分析和数值计算,得出了在开关的材料、结构参数基本不变的情况下,通过改变天关的偏置电压Vbias改变了开关"关"态和"开"态的电容比。在本文的研究中,没有考虑可动桥与介质膜之间的非弹性碰撞对开关维持电压产生的影响。由于开关的材料及结构参数(除gj之外)均未变化,因此开关的性能如阈值电压、开启时间等均变化不大(本文未讨论)。研究结果表明:使用脉冲电压作偏置电压时,可以将介质膜的厚度降低到5nm左右,而该厚度基本上达到了介质膜的粗糙度,达到了介质膜的最小厚度极限[5],开关的电容比可达3800,因而将极大地改善MEMS膜开关的插入损耗和隔离度等参数。本文的研究结论为提高MEMS膜开关及其衍生器件的性能提供了一条新途径。
参考文献
[1] Yao J J,Chang,M F,A surfac micromachined minia-ture swich for telecommunications applications whth signal frequencies from DC up to 4 GHz.In:int Conf Solid-State Sensors and Actuators,Dig,Stockholm,sweden,June 1995:384~387.
[2] Goldsmith C,Randall J,et al.Characteristics of mi-cromachined switches at microwave frequencies.In:IEEE MTT-Sint Microwave Symp Dig,San Francis-co,CA.June 1996:1141~1144.
[3] Park J Y,Geun H K,et al.Monolithically integrated micromachined RF MEMS Capacitive switches.Sen-sors and Actuators A.,2001,89(5):88~94.
[4] Muldavin J B,Rebeiz G M.High-Isolation MEMS shunt switches-Part 2:Design.IEEE Trans Micro-wave Theory Tech.2000,48(6):1053~1056.
[5] Muldavin J B, Rebeiz G M.High-Isolation MEMS shunt switches-Part1:Modeling,IEEE Trans Micro-wave Theory Tech.2000,48(6):1045~1052.
[6] Osterberg P,Yie H,et al.Self-consistent Simulation and modeling of electrostatically deformed diqphragms.Proc IEEE MEMS Conf.,Jan,1994:28~32.
如何成为一名优秀的射频工程师,敬请关注: 射频工程师养成培训
上一篇:高山微波站的防雷
下一篇:LRL校准法及其在微波测量中的应用

