- 易迪拓培训,专注于微波、射频、天线设计工程师的培养
引领新一代高级封装的光刻技术
在当今飞速发展的电子环境中,芯片制造商和封装技术供应商们发现传统的前段制造设备,诸如光刻步进器等,可能会实现成本高效的后段工艺流程(BEOL)器件封装。尽管高级封装市场的发展空间最初是被PCs行业的蓬勃发展带动起来的,但是现在它们已经不再是主要的增长催化因素。通信以及手持设备,如手机、PDAs(个人数字助理)、便携式游戏机以及个人通讯系统正在成为新增长阶段的推动因素。随着数字消费应用的爆炸式发展-性能和波形系统成为必须启用高级封装(AP)技术的必要条件。在未来五年内,预计通讯芯片组、图形处理器、集成无源元件以及高速PC内存元件将成为AP技术的主要诉求。随着领先的逻辑芯片制造商们需求量的不断增大,我们共同见证了AP市场的成长过程。然而,这一细分市场的另一个转折点可能会来自高速PC内存元件对高级封装技术的诉求。
不管终端设备的推动因素如何强劲,仅高性能封装技术的需求不断升级,就带动了金凸块技术和锡铅凸块技术的需求增长,同时获得增长的还包括晶圆级封装技术和后护层技术。本文将分析当前的以及正在不断涌现的AP应用,其中光蚀刻设备以其突出的优势将获得部署良机。
主要的AP光刻市场
光刻技术是影响晶圆植球品质的最重要因素之一。如图1所示,推动AP市场发展的因素是多元化的。举例说明,液晶显示器(LCDs)是一款产量非常高的成熟产品,也是金凸块技术的主要供应市场。新的晶圆级封装(WLP)技术将即将渗透到微处理器和射频(RF)器件市场。同时我们也期待PPL技术能够在高级器件封装领域获得增长
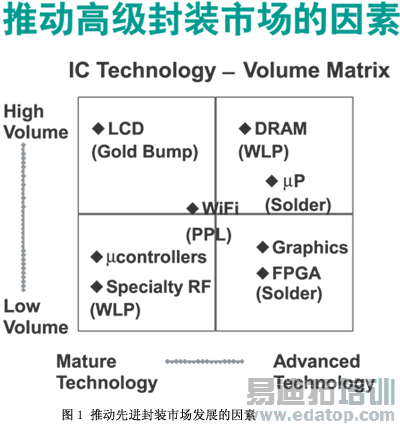
金凸块技术
金凸块技术主要用于液晶显示器(LCD)面板上驱动ICs的封装。尽管日本已经成为业界领先的LCD面板和驱动ICs制造国,然而,出于成本和供应链等环节的考量,显示器制造还是在向其它地区的商业制造厂平稳过渡-台湾、韩国以及中国, 其中向中国的制造厂过渡正在逐步攀升。必然的,这一变迁催生了这些地区对更高级封装、装配以及测试功能的需求,特别是台湾地区和中国,预计将继续加大对金凸块技术的投入。
LCD 驱动ICs 是利润相对较低、对成本相对比较敏感的器件,那么就更加需要成本高效的制造方法。市场研究机构Gartner Dataquest 的数据表明全球范围内,LCD驱动ICs的终端产品消费-包括液晶电视(LVD TVs)、掌上型电脑(Mobile PCs)、平板显示器以及手机等-将由2005年的10.7亿美元增长到2008年的14.6亿美元(图2)。一个必然的结果是大多数厂商正在积极地扩张他们的金凸块能力。一篇最近发表的文章指出Chipbond (台湾欣邦电子)-台湾领先的金凸块技术应用厂商-预计到后半年度,月产能将暴涨44%,跃升至26万只晶圆。另外,台湾的半导体厂商飞信半导体股份有限公司(IST)的产能有望于2006年获得64%的增长,达到18万只晶圆。预计中国也将于2006年底提高新增金凸块生产线的产能,以满足LCD驱动ICs的制造需求。而且,特别值得一提的是:到2008年,在全球金凸块技术市场中,中国的金凸块市场份额将增长到10%。(由TechSearch International预测)。

尽管金凸块光刻技术能够达到与前段半导体制造相同的良率和生产需求,然而后段光刻技术仍然需要考虑几个不同的变化。首先金凸块技术需要厚的(厚度为15 - 30 (m)光刻胶膜,无疑将会引起光刻工艺流程对更长焦深的需求。1X步进器能够为光刻工艺流程的成像提供更大的焦深并提供调整各种位置的机械装置,因而实现了更可靠的工艺流程控制。在把图形复制到厚光刻胶膜上的同时,也将更多的重点放在了一致的临界尺寸(CD)控制上,这一控制对于保证整个晶圆上凸块高度的一致是非常关键的。除了图形的品质之外,先进的图形对准能力也是满足金凸块制造需求的关键因素。基于上述各个因素,显然,电子发射光刻技术已然成为满足业界对金凸块工艺处理需求的关键技术诉求之一。
锡铅凸块技术
预计锡铅凸块技术在商业和自用细分市场依然会保持强劲的增长势头。尽管很多战略性的凸块技术还需要自行完成,但是元器件制造商们正在逐步加大将封装生产外包给制造厂和封装/装配车间的力度。
由于铅锡凸块的主要发展动力是性能,因此高端技术环境下的元器件制造对铅锡凸块的采用基本上是并行的。由于I/O的量很大,焊垫无法安装在晶粒周围,亦或是采用引线键合的方法会危及到信号的传播速度,因此倒装晶片方法已经成为晶圆分割的强制技术。
铅锡凸块技术趋向于大量地用于尖端逻辑元器件的封装应用-迄今为止,主要是面向PCs机的微处理封装。目前,由Sony公司的PlayStation3和微软公司的Xbox 领军的市场对高级游戏系统的需求强劲,因此市场重心正在向游戏处理器领域转移。对速度和波形因素的需求使得传统的封装方法已经无法应用在这些系统上。尽管铅锡凸块技术的发展最初是由高速的I/O数量(high-I/O-count)和高速的晶体管数量(high-transistor-count)器件带动起来的,但是随着整个半导体行业架构的成熟,特别是在可靠性和基板显像方面,铅锡凸块技术在中速的I/O数量(mid-I/O-count)器件方面的应用同时也在稳步上升。
铅锡凸块技术发展的关键技术推动力来自持续的器件尺寸紧缩。在130nm 技术标准下,约有30%的逻辑芯片需要凸块技术。但是在90nm 技术标准下,这一数据跃升到60%,当发展到了65nm器件量产制造时,金凸块技术的需求则攀升至80%以上。
来自去除铅锡凸块尖峰以及减少铅锡凸块坡度的持续动力共同形成了光刻工艺流程中更精确的校正需求(图3A中显示了铅锡凸块的钝化堆叠)。焊球的高度以及与焊接垫的相对位置是在流程中形成的,这些对于保持更高的良率是至关重要的。典型的焊 球高度一般从20微米到100微米,图形范围从15 x 15 到500 x 500平方微米。(图3B展示了铅锡凸块的截面图)。
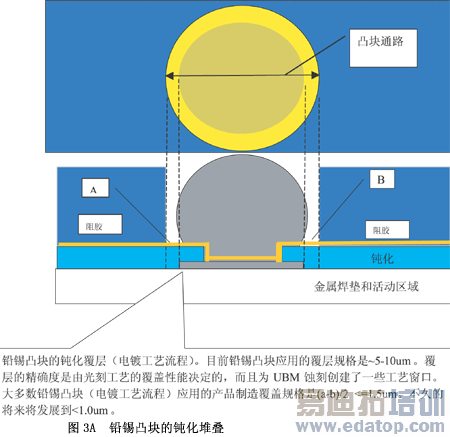
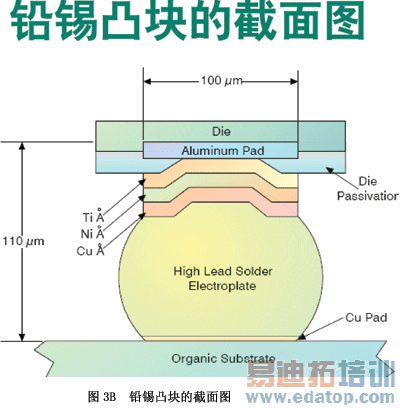
对于先进的高性能IC,铅锡凸块的形成工艺流程一般是利用电镀焊锡沉积方法实现的。在焊锡电镀工艺流程之前,需要使用厚阻胶光刻工艺流程进行电镀成形。焊锡电镀工艺的典型光阻胶厚度范围从 50 um到 120 um不等。由于电镀的铅锡凸块用作UBM(凸块下金属化)的蚀刻掩膜,因此在厚阻胶曝光工艺流程中图形印刷到晶圆上的精确度就显得极为重要。准确的图形印刷能够确保蚀刻工艺流程中UBM不会过度蚀刻,因而突破了钝化覆盖的设计规则,如图3B所示。过度蚀刻的UBM将会导致IC的 I /O焊垫损坏,影响晶圆I /O焊垫上的铅锡凸块密封性能,最终将导致焊点失效,以及与封装水平可靠性相关的缺陷。
WLP(晶圆级封装)
WLP的最初萌芽是由用于移动电话的低速I/O (low-I/O)、低速晶体管元器件制造带动起来的,如无源的片上感应器和功率传输ICs等,目前WLP正处于发展阶段,受到蓝牙、GPS(全球定位系统)元器件以及声卡等应用的推动,需求正在逐步增长。当发展到3G手机生产阶段时,预计各种各样的手机内容全新应用将成为WLP的又一个成长动力,其中包括电视调谐器(TV tuners)、调频发射器(FM transmitters)以及堆栈存储器等。随着存储器件制造商开始逐步实施WLP,将引领整个行业的模式化变迁。来自Semico的市场研究表明DDR3 DRAM (双数据速率同步动态随机存储器)将会成为WLP的重要发展动力,计划到2007年将发展到整个DRAM市场的10%左右,到2008年攀升至30%左右(参见图4)。一言以蔽之,对功能不断增加的高级PC内存的需求,如DDR III的需求,将推动封装业对WLP或倒装晶片技术的使用。

PPL(后护层)
这一细分市场由一系列加载到互联线上的层所组成,目的是改善器件的功能和器件的可靠性。这些层包括I/O 再分布、高密度传输线、片上集成无源元件、实现功率分布的厚铜箔以及压力缓冲层等。对于65nm的器件生产,由于主要的产品是高端逻辑器件,因此压力缓冲层是必须具备的层,而其它的层则主要用于无线设备上领先的模拟器件和射频产品。
这些后护层要求非常严格的光刻技术,那么提高分辨率将是关键的成功因素。1X步进器赋予了晶圆级封装工艺中厚膜处理意义非凡的技术和经济优势。镜头的孔径缩少,使得色差校准的得以延伸,从波长350nm到450nm。孔径缩小确保了对宽带阻胶的处理,普遍用于晶圆级的IC封装技术中。此外,当镜头分辨率达到2-micron时,也能够实现厚光阻胶曝光所需要的长焦深。简单的、五元素、折反光光学设计实现了最大的功率传输以及较高的晶圆平面光照。由于WLP市场使用的大多数光阻胶需要较大的曝光量,因此较高的晶圆平面光照提供了产能增加和生产力增长等竞争优势。除了要满足每一层的个别技术性能标准之外,在不影响工艺良率的前提下,PPL光刻技术还需要具备能够曝光高长宽比结构的能力。集成的1X步进器和宽带曝光系统,如一体的Ultratech AP200 和 AP300系统能够在晶圆平面上实现最大的照度,在芯片制造商向PPL时代过渡时,帮助他们满足复杂的工艺需求。
PPL生产正在渗透到更多的制造厂中;目前它在制造厂的发展现状正是5年前倒装芯片技术的发展写照。尽管目前只有很少的部署,然而包括光刻设备芯片组的同一设备可以同时面向这两种工艺流程。
总结
与前几年相比,目前的高级半导体封装市场所处的环境已经是今非昔比了。封装正在被赋予一种更为战略化的意义。芯片封装的意义不再仅限于保护芯片包围的内部,而是为新型器件增加了更多的优势,不论这些优势集中在芯片成本、尺寸、性能亦或是一些其它的变量。随着器件的尺寸持续紧缩,紧跟摩尔定律的唯一办法就是将一部分功能转移到封装自身,使得封装更加智能化。
在确保封装技术得到最大限度的优化过程中,先进的光刻系统和其它制造设备正在扮演着越来越重要的角色。毫无疑问,这些产品为集成器件制造商、晶圆厂以及类似的封装车间提供了至关重要的设备和技术,在保证生产能力的同时,确保他们的AP技术始终处于创新的前沿。
本文作者:SafetyManish Ranjan,Ultratech公司产品市场总监
13.56MHz NFC天线,13.56MHz RFID天线设计培训课程套装,让天线设计不再难
上一篇:国外防伪标签在烟酒和药品上的应用
下一篇:应用于倒装芯片的铜钉头凸点技术


